特別說(shuō)明:本文由學(xué)研匯技術(shù) 中心原創(chuàng)撰寫(xiě),旨在分享相關(guān)科研知識(shí)。因?qū)W識(shí)有限,難免有所疏漏和錯(cuò)誤,請(qǐng)讀者批判性閱讀,也懇請(qǐng)大方之家批評(píng)指正。
原創(chuàng)丨彤心未泯(學(xué)研匯 技術(shù)中心)
編輯丨風(fēng)云
二維過(guò)渡金屬二鹵屬化合物(TMDs)及其異質(zhì)結(jié)構(gòu)是下一代電子學(xué)、自旋電子學(xué)和山谷電子學(xué)以及光電子學(xué)應(yīng)用的有前途的平臺(tái)。由于缺乏單疇TMD的逐層生長(zhǎng)策略,大規(guī)模二維異質(zhì)結(jié)構(gòu)的生長(zhǎng)仍然存在重大挑戰(zhàn)。目前最先進(jìn)的生長(zhǎng)方法需要一個(gè)不理想的二維材料轉(zhuǎn)移過(guò)程來(lái)注入Si技術(shù)。盡管最近報(bào)道了一種使用激光照射成核點(diǎn)來(lái)生產(chǎn)單域TMD陣列的“非外延”方法,但這種方法不可避免地會(huì)伴隨TMD中的不良損傷。此外,當(dāng)嘗試垂直生長(zhǎng)第二異質(zhì)層時(shí),橫向異質(zhì)結(jié)構(gòu)將較好地形成。
然而,TMDs的制備仍存在以下問(wèn)題:
1、將半導(dǎo)體2D異質(zhì)結(jié)構(gòu)集成到工業(yè)平臺(tái)上一直具有挑戰(zhàn)性。
構(gòu)建二維異質(zhì)結(jié)構(gòu)最常見(jiàn)的方法是通過(guò)對(duì)二維薄片的機(jī)械剝離和堆疊,這是一種試錯(cuò)操作,因此結(jié)構(gòu)尺寸嚴(yán)重受限,組裝時(shí)間長(zhǎng)。
2、缺乏單疇TMD的逐層生長(zhǎng)策略。
大規(guī)模二維異質(zhì)結(jié)構(gòu)的生長(zhǎng)仍然存在重大挑戰(zhàn)。目前最先進(jìn)的生長(zhǎng)方法需要一個(gè)不理想的二維材料轉(zhuǎn)移過(guò)程來(lái)注入Si技術(shù),不可避免地會(huì)伴隨TMD中的不良損傷。
有鑒于此,麻省理工學(xué)院的Jeehwan Kim等人介紹了一種確定性的受限生長(zhǎng)技術(shù),可以獲得晶圓級(jí)單疇二維單層陣列及其在任意基底上的異質(zhì)結(jié)構(gòu)。通過(guò)在兩英寸襯底上的SiO2掩膜圖案定義一個(gè)選擇性生長(zhǎng)區(qū)域,從幾何上限制了第一組核的生長(zhǎng)。由于在微米級(jí)SiO2溝槽上的生長(zhǎng)時(shí)間大大縮短,在引入第二組核之前,通過(guò)第一組核的短時(shí)間生長(zhǎng)來(lái)填充溝槽,從而無(wú)需外延播種,在任意基底上獲得了晶圓級(jí)單疇單層WSe2陣列。用同樣的原理進(jìn)一步生長(zhǎng)過(guò)渡金屬二鹵族化合物,形成單疇MoS2/WSe2異質(zhì)結(jié)構(gòu)。

技術(shù)方案:
1、闡明了TMD陣列合成機(jī)理
作者闡明了TMD的生長(zhǎng)過(guò)程,并通過(guò)DFT計(jì)算解釋了合成機(jī)理。
2、合成了單疇WSe2
WSe2的橫向生長(zhǎng)速率約為0.4 μm min-1,第二次成核的培養(yǎng)時(shí)間約為5 min。進(jìn)一步延長(zhǎng)生長(zhǎng)時(shí)間,形成多疇多晶WSe2。
3、驗(yàn)證了單疇TMD的電化學(xué)質(zhì)量
作者在BL-WSe2上制作了FET陣列以驗(yàn)證用限制生長(zhǎng)法制備的單疇TMD的電學(xué)質(zhì)量,該材料展現(xiàn)出高場(chǎng)效應(yīng)遷移率和高飽和電流。
4、進(jìn)一步發(fā)展限制生長(zhǎng)策略
作者進(jìn)一步發(fā)展了限制生長(zhǎng)策略,以滿足邏輯和存儲(chǔ)領(lǐng)域的工業(yè)化需求,這需要在Si晶圓的非晶表面上形成單晶TMD,并在晶圓規(guī)模上形成單晶異質(zhì)結(jié)構(gòu)。
技術(shù)優(yōu)勢(shì):
1、開(kāi)發(fā)了“非外延單晶生長(zhǎng)”方法
可在現(xiàn)有工業(yè)硅晶圓上生長(zhǎng)出純凈、無(wú)缺陷的二維材料。通過(guò)新方法,用TMD制造了一個(gè)簡(jiǎn)單的功能晶體管,這種材料在納米尺度上的導(dǎo)電性比硅更好。
2、實(shí)現(xiàn)了晶圓級(jí)在單疇單層WSe2陣列和單層MoS2/WSe2異質(zhì)結(jié)構(gòu)
本文開(kāi)發(fā)的生長(zhǎng)技術(shù)可以實(shí)現(xiàn)具有臨界吉布斯自由能差的逐層合成,在任意基底上實(shí)現(xiàn)晶圓級(jí)單疇均質(zhì)分子層和異質(zhì)分子層。
3、實(shí)現(xiàn)了選擇性/限制生長(zhǎng)制備單疇MoS2/WSe2異質(zhì)結(jié)構(gòu)
選擇性地在a-SiO2溝槽內(nèi)生長(zhǎng)WSe2。所得的WSe2薄膜為單疇單層。重復(fù)這一過(guò)程,通過(guò)對(duì)第二MoS2層進(jìn)行限制生長(zhǎng),獲得單疇MoS2/WSe2異質(zhì)結(jié)構(gòu)。
4、進(jìn)一步發(fā)展限制生長(zhǎng)策略將滿足工業(yè)化需求
應(yīng)用于單晶藍(lán)寶石晶片上的受限TMD生長(zhǎng)以制備單晶TMD。MoS2在a-HfO2上的額外限制生長(zhǎng)允許雙分子層和三層MoS2逐層生長(zhǎng)。
TMD陣列合成機(jī)理
首先在c-Al2O3或a- HfO2沉積的Si晶圓上涂上a-SiO2,然后在a-SiO2上形成微米大小的溝槽陣列。然后選擇性地在a-SiO2溝槽內(nèi)生長(zhǎng)WSe2。所得的WSe2薄膜為單疇單層。重復(fù)這一過(guò)程,通過(guò)對(duì)第二MoS2層進(jìn)行限制生長(zhǎng),獲得單疇MoS2/WSe2異質(zhì)結(jié)構(gòu)。由DFT計(jì)算。與a-SiO2表面相比,WO3團(tuán)簇、Se團(tuán)簇、WSe2團(tuán)簇與c-Al2O3、a-HfO2的結(jié)合作用更強(qiáng)。這表明簇優(yōu)先與底物結(jié)合,而不是a-SiO2,導(dǎo)致選擇性WSe2生長(zhǎng)。還通過(guò)在相同的化學(xué)氣相沉積(CVD)生長(zhǎng)條件下,在c-Al2O3、a-HfO2和a-SiO2基質(zhì)上同時(shí)生長(zhǎng)WSe2,實(shí)驗(yàn)證實(shí)了它們的選擇性。

圖 選擇性單域TMD陣列原理及合成機(jī)理
WSe2的單疇合成過(guò)程
WSe2的橫向生長(zhǎng)速率約為0.4 μm min-1,第二次成核的培養(yǎng)時(shí)間約為5 min。在10-μm溝槽上生長(zhǎng)WSe2超過(guò)培養(yǎng)時(shí)間后,溝槽中會(huì)出現(xiàn)多個(gè)疇。單個(gè)WSe2三角形占據(jù)了溝槽面積的70%,其余區(qū)域包含多個(gè)域。進(jìn)一步延長(zhǎng)生長(zhǎng)時(shí)間,形成多疇多晶WSe2。與單疇區(qū)域相比,多疇區(qū)域的光致發(fā)光強(qiáng)度顯著降低。統(tǒng)計(jì)數(shù)據(jù)表明在10 μm尺寸的多個(gè)溝槽中,約25%的溝槽包含兩個(gè)以上的疇。另一方面,當(dāng)溝槽尺寸限制為2 μm時(shí),無(wú)論初始形核事件的位置如何,每個(gè)被檢查區(qū)域都只形成了一個(gè)單一的疇。進(jìn)一步的增長(zhǎng)導(dǎo)致核的合并填滿整個(gè)溝槽。由于最終填充在封閉溝槽中的WSe2陣列源于單疇成核事件,所有的WSe2陣列在晶圓上都是單晶。還證實(shí)了大約97%的溝槽區(qū)域被WSe2填充,溝槽的完全填充是在第二層核形成的孵化時(shí)間內(nèi)完成的。E1 2g峰位置的拉曼映射和1.65 eV的光致發(fā)光映射證實(shí)在所有溝槽中生長(zhǎng)的WSe2確實(shí)是單層的。
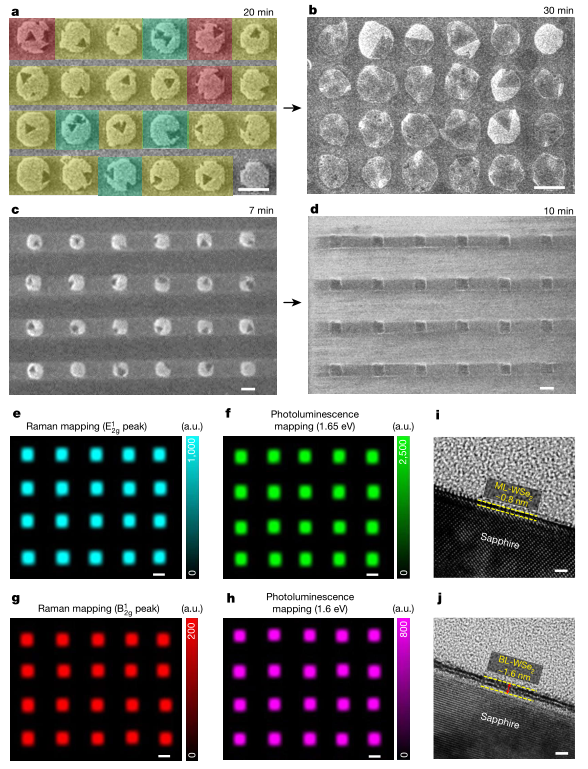
圖 WSe2的選擇性單疇合成和逐層約束生長(zhǎng)
電化學(xué)質(zhì)量驗(yàn)證
為了驗(yàn)證用限制生長(zhǎng)法制備的單疇TMD的電學(xué)質(zhì)量,在生長(zhǎng)在2英寸晶圓上的BL-WSe2上制作了FET陣列。在Vds =?1 V時(shí),場(chǎng)效應(yīng)遷移率高達(dá)103.5 cm2 V-1 s-1。此外,通過(guò)輸出特性觀察到飽和電流高達(dá)465 μA μm-1。用限制ML-/BL-WSe2制備的FET的電學(xué)性能可與單晶WSe2 FET的最佳性能相媲美,并且類似那些基于片狀ML-/BL-WSe2 FET。對(duì)FET陣列進(jìn)行了關(guān)于每寬度離子和統(tǒng)計(jì)分析。FET的離子/寬度和μeff均呈高斯分布,離子密度的平均值為89.9 μA μm-1。此外,還表征了用受限ML-WSe2制備的FET,其電性能與用受限BL-WSe2制備的FET相當(dāng)。
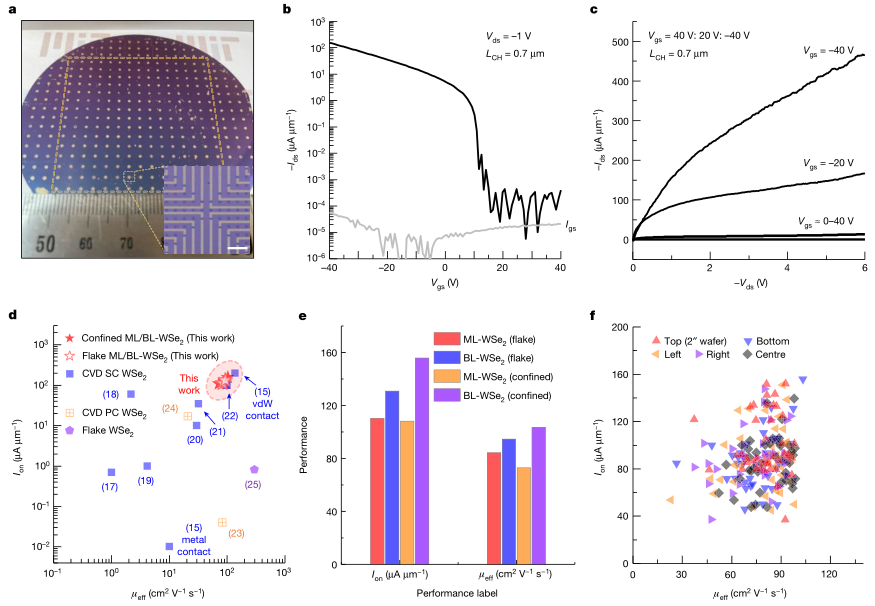
圖 受限BL-WSe2的電學(xué)表征
限制生長(zhǎng)策略發(fā)展
進(jìn)一步發(fā)展了限制生長(zhǎng)策略,以滿足邏輯和存儲(chǔ)領(lǐng)域的工業(yè)化需求,這需要在Si晶圓的非晶表面上形成單晶TMD,并在晶圓規(guī)模上形成單晶異質(zhì)結(jié)構(gòu)。首先應(yīng)用于單晶藍(lán)寶石晶片上的受限TMD生長(zhǎng),以實(shí)現(xiàn)在溝槽尺寸減小的Si晶片上沉積a- HfO2上的單晶TMD。所有單疇成核事件都完全發(fā)生在1 μm溝槽內(nèi),并成功生長(zhǎng),填滿溝槽,在晶圓尺度上在非晶表面生成單晶ML-MoS2。此外,MoS2在a-HfO2上的額外限制生長(zhǎng)允許雙分子層和三層MoS2逐層生長(zhǎng)。通過(guò)在a-HfO2/Si晶圓上生長(zhǎng)的ML-/BL-MoS2上制造FET,觀察到a-HfO2上限制TMD的優(yōu)異電氣特性,而沒(méi)有任何轉(zhuǎn)移過(guò)程。制備的ML-/BL-MoS2 FET測(cè)量的Ids-Vds的最大離子密度為86.7 μA μm-1 (ML-MoS2)和129.3 μA μm-1 (BL-MoS2), μeff為62.2 cm2 V-1 s-1和88.61 cm2 V-1 s-1。估計(jì)了ML-/BL-MoS2 FET的離子每寬度值的23.8%和25.2%的變化,ML-/BL-MoS2 FET的μeff值的20.3%和24.9%的變化,器件產(chǎn)率為90.5%。
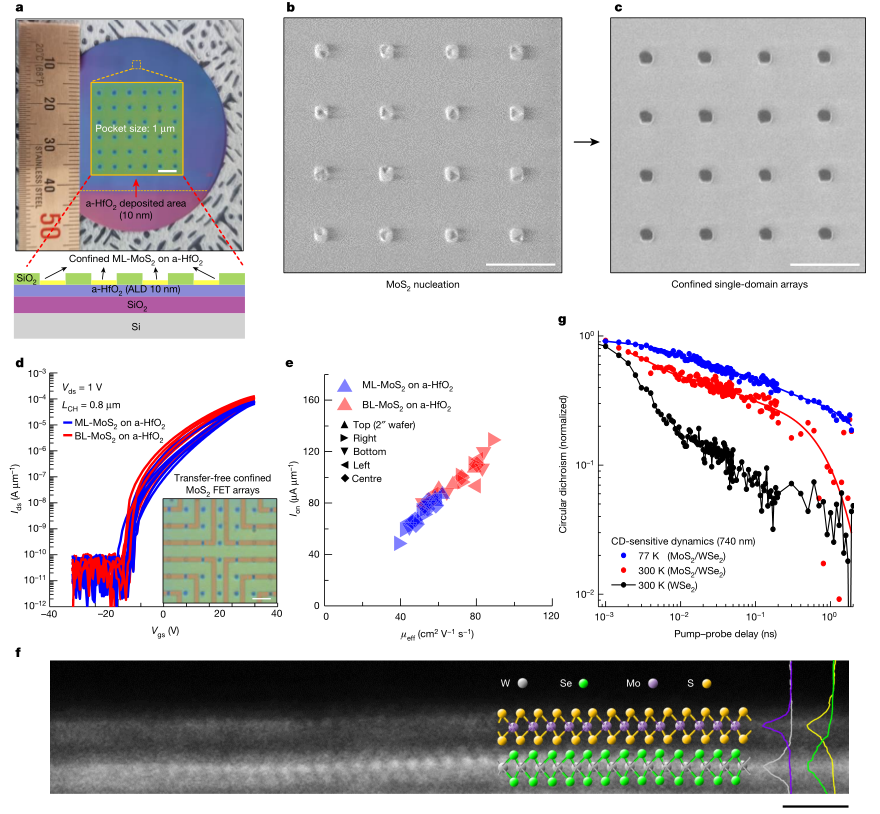
圖 硅晶片上a-HfO2的限制TMD生長(zhǎng)以及ML-WSe2和異質(zhì)雙分子層(MoS2/WSe2)中的谷極化層間激發(fā)
總之,作者展示了在晶圓尺度上使用受限生長(zhǎng)技術(shù)合成二維TMD單域陣列。這種生長(zhǎng)技術(shù)可以實(shí)現(xiàn)具有臨界吉布斯自由能差的逐層合成,在任意基底上實(shí)現(xiàn)晶圓級(jí)單疇均質(zhì)分子層和異質(zhì)分子層。此外,密閉TMD層表現(xiàn)出優(yōu)異的電學(xué)性能,與片狀TMD相當(dāng)。因此,局限生長(zhǎng)技術(shù)不僅可以克服二維材料在晶圓尺度上動(dòng)力學(xué)控制的困難,這一直是二維TMD的主要障礙,而且顯示出大規(guī)模制造各種單晶范德華集成的巨大潛力,為構(gòu)建基于二維材料的電子平臺(tái)提供了一條路徑。
參考文獻(xiàn):
Kim, K.S., Lee, D., Chang, C.S. et al. Non-epitaxial single-crystal 2D material growth by geometric confinement. Nature (2023).
DOI:10.1038/s41586-022-05524-0
https://doi.org/10.1038/s41586-022-05524-0











