等離子體處理已廣泛應用于提高氧化物晶體管的性能。然而,背柵晶體管的實際活性通道通常埋藏在接近介質界面的地方,無法通過等離子體有效調節。鑒于此,湖南大學Yuan Liu、Yiliu Wang等報告了一種底部等離子體處理策略,可以直接調節氧化物通道。
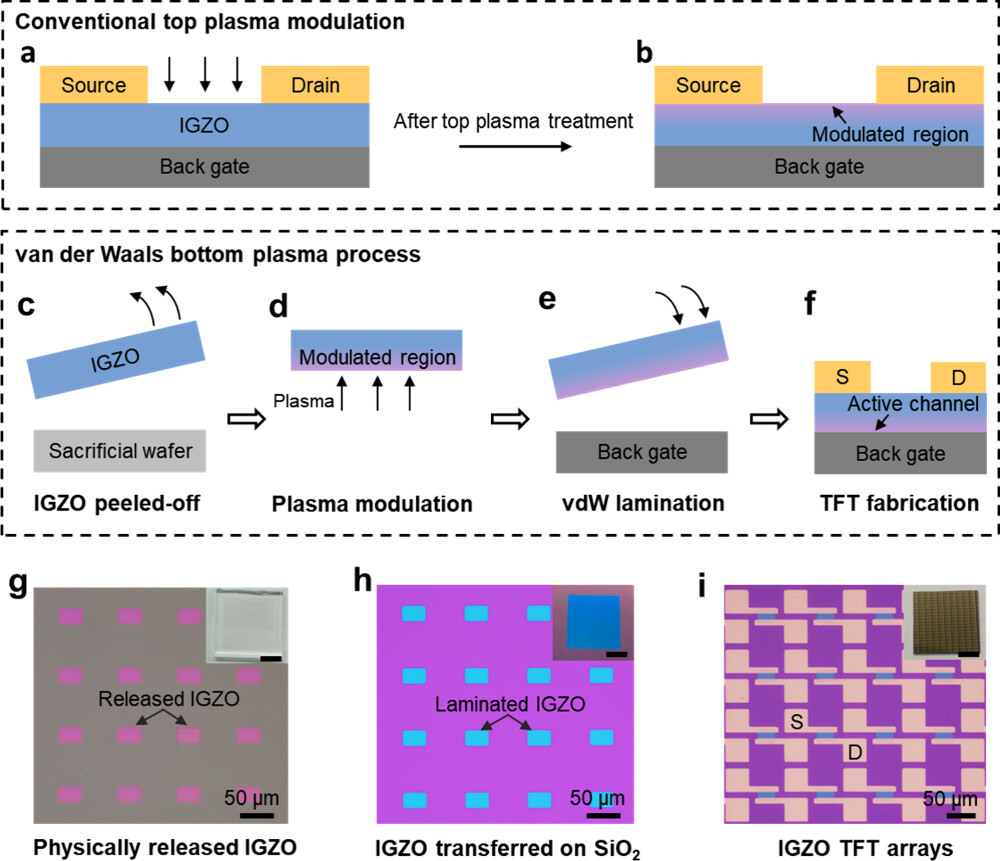
本文要點:
(1)在這一過程中,沉積后的氧化物通道可以通過范德華層積工藝從犧牲襯底上物理剝離,從而暴露底部通道區域進行直接的等離子體處理。
(2)處理后,銦鎵鋅氧化物(IGZO)晶體管表現出4 × 108的高開關比和超過25 cm2 V-1 s-1的高載流子遷移率,比傳統頂部等離子體處理的控制設備高出4倍以上。此外,詳細的X射線光電子能譜測量確認,性能的提升源自于活性底部通道區域內氧空位的鈍化和氮摻雜。
Xiaokun Yang, Donglin Lu, Rui He, Yang Chen, Zheyi Lu, Liting Liu, Songlong Liu, Quanyang Tao, Likuan Ma, Shuimei Ding, Xiao Liu, Yunxin Li, Yiliu Wang, Lei Liao, and Yuan Liu
Nano Letters Article ASAP
DOI: 10.1021/acs.nanolett.5c00313
https://doi.org/10.1021/acs.nanolett.5c00313



















